

所有CCR Technology COPRA 的電漿源皆採無燈絲式(filamentless)低壓感應耦合RF射頻設計,電漿源內建可調式匹配網路,可讓電漿能源之傳輸效率達至最佳。而 COPRA 所產生的中性電漿(亦即電漿內有著接近等量的離子與電子,所形成的電荷平衡狀態),在導體或絕緣體基材上的薄膜沈積、蝕刻或表面改質等應用上,可有效減少電荷累積的狀態。
由於採用獨特電漿激發機制,不論製程所使用的是哪種氣體,COPRA 電漿源在氣體解離率表現均超過 90%,讓 COPRA 電漿源所產生的電漿密度可達 1x1012/cm3 以上,對各種類別的應用更具重要性;各種款式的電漿源也可對應客製化的尺寸需求。CCR Technology 的 COPRA 電漿源,其特色如下:
- 能產生極大之離子電流密度
- 離子能量(Ion Energy) 可獨立控制,不因RF電源的輸出大小而變化。可針對特定製程設定所需的離子能量,抑制膜質缺陷的生成
- 可廣泛應用於各種電漿製程,例如:離子輔助蒸鍍、離子輔助反應性濺鍍、電漿輔助化學氣相沉積、電漿表面改質與清潔、電漿蝕刻應用等


COPRA Linear Sources

LS360x200-GRPE
- Plasma Opening: 360mmx200mm
- Matching: Integrated Remote Match
- RF Power: 5kW @ 13.56MHz
- Pressure Range: 2x10-4 ~ 1x10-2 mbar
- Substrate Size (static): -
- Substrate Width (dynamic): 300mm

LS500x500-DPRPE
- Plasma Opening: 500mmx500mm
- Matching: Integrated Remote Match
- RF Power: 5kW @ 13.56MHz
- Pressure Range: 5x10-4 ~ 1x10-1 mbar
- Substrate Size (static): 400mmx400mm
- Substrate Width (dynamic): -

LS670x203-GRPE
- Plasma Opening: 670mmx200mm
- Matching: Integrated Remote Match
- RF Power: 5kW @ 13.56MHz
- Pressure Range: 2x10-4 ~ 1x10-2 mbar
- Substrate Size (static): -
- Substrate Width (dynamic): 600mm

LS800x250-DPRPE
- Plasma Opening: 800mmx250mm
- Matching: Integrated Remote Match
- RF Power: 6kW @ 13.56MHz
- Pressure Range: 5x10-4 ~ 1x10-1 mbar
- Substrate Size (static): -
- Substrate Width (dynamic): 700mm

LS1100x202-GRPE
- Plasma Opening: 1100mmx200mm
- Matching: Integrated Remote Match
- RF Power: 6kW or 8kW @ 13.56MHz
- Pressure Range: 3x10-4 ~ 1x10-2 mbar
- Substrate Size (static): -
- Substrate Width (dynamic): 1000mm
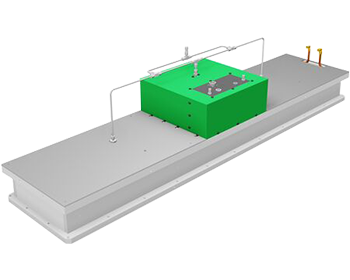
LS1300x202-GRPE
- Plasma Opening: 1300mmx200mm
- Matching: Integrated Remote Match
- RF Power: 6kW or 8kW @ 13.56MHz
- Pressure Range: 5x10-4 ~ 1x10-2 mbar
- Substrate Size (static): -
- Substrate Width (dynamic): 1200mm
COPRA Ring Sources

RS400-DPR
- Plasma Opening: Ø 400 mm
- Matching: Integrated Remote Match
- RF Power: 5kW @ 13.56MHz
- Pressure Range: 5x10-4 ~ 1x10-1 mbar
- Substrate Size (static): Ø 300 mm (12"Wafer)
- Substrate Width (dynamic): -

RS500x500-DPR
- Plasma Opening: 500mmx500mm
- Matching: Integrated Remote Match
- RF Power: 5kW @ 13.56MHz
- Pressure Range: 5x10-4 ~ 1x10-1 mbar
- Substrate Size (static): 400mmx400mm
- Substrate Width (dynamic): -

RS700x600-DPR
- Plasma Opening: 700mmx600mm
- Matching: Integrated Remote Match
- RF Power: 6kW or 10kW @ 13.56MHz
- Pressure Range: 5x10-4 ~ 1x10-1 mbar
- Substrate Size (static): 550mmx450mm
- Substrate Width (dynamic): -

RS850x850-DPR
- Plasma Opening: 850mmx850mm
- Matching: Integrated Remote Match
- RF Power: 6, 10 or 15kW @ 13.56MHz
- Pressure Range: 5x10-4 ~ 1x10-1 mbar
- Substrate Size (static): 700mmx700mm
- Substrate Width (dynamic): -

RS1000x300-DPR
- Plasma Opening: 1000mmx300mm
- Matching: Integrated Remote Match
- RF Power: 6 or 10kW @ 13.56MHz
- Pressure Range: 5x10-4 ~ 1x10-1 mbar
- Substrate Size (static): -
- Substrate Width (dynamic): 900mm

RS1000x402-DPR
- Plasma Opening: 1000mmx400mm
- Matching: Integrated Remote Match
- RF Power: 6 or 10kW @ 13.56MHz
- Pressure Range: 5x10-4 ~ 1x10-1 mbar
- Substrate Size (static): -
- Substrate Width (dynamic): 900mm
COPRA Round Sources

DN 160-CF-GM
- Plasma Opening: Ø 84 mm
- Matching: Manual
- RF Power: 0.6kW @ 13.56MHz
- Pressure Range: 1x10-4 ~ 1x10-2 mbar
- Substrate Size (static): Ø 80 mm (3"Wafer)
- Substrate Width (dynamic): -

DN201-X-GM
- Plasma Opening: Ø 110 mm
- Matching: Manual
- RF Power: 1.2kW @ 13.56MHz
- Pressure Range: 1x10-4 ~ 1x10-1 mbar
- Substrate Size (static): Ø 100 mm (4"Wafer)
- Substrate Width (dynamic): -

DN250-CF-GRPE
- Plasma Opening: Ø 152 mm
- Matching: Remote
- RF Power: 1.6kW @ 13.56MHz
- Pressure Range: 1x10-4 ~ 1x10-2 mbar
- Substrate Size (static): Ø 150 mm (6"Wafer)
- Substrate Width (dynamic): -

DN251-ISO-K-EGRPE
- Plasma Opening: Ø 154 mm
- Matching: Integrated Remote Match
- RF Power: 3kW @ 13.56MHz
- Pressure Range: 1x10-4 ~ 1x10-2 mbar
- Substrate Size (static): Ø 150 mm (6"Wafer)
- Substrate Width (dynamic): -

DN401-GRPE
- Plasma Opening: Ø 244 mm
- Matching: Integrated Remote Match
- RF Power: 5kW @ 13.56MHz
- Pressure Range: 1x10-4 ~ 1x10-2 mbar
- Substrate Size (static): Ø 200 mm (8"Wafer)
- Substrate Width (dynamic): -

DN501-GRPE
- Plasma Opening: Ø 380 mm
- Matching: Integrated Remote Match
- RF Power: 5kW @ 13.56MHz
- Pressure Range: 1x10-4 ~ 1x10-2 mbar
- Substrate Size (static): Ø 300 mm (12"Wafer)
- Substrate Width (dynamic): -
COPRA Built-in Sources

IS201-G(I)R(PE)
- Plasma Opening: Ø 110 mm
- Matching: Integrated Remote Match
- RF Power: 1.2kW @ 13.56MHz
- Pressure Range: 1x10-4 ~ 1x10-1 mbar
- Substrate Size (static): up to 760mm calotte/dome size
- Substrate Width (dynamic): -

IS201-EG(I)R(PE)
- Plasma Opening: Ø 110 mm
- Matching: Integrated Remote Match
- RF Power: 1.2kW @ 13.56MHz
- Pressure Range: 1x10-4 ~ 1x10-1 mbar
- Substrate Size (static): up to 760mm calotte/dome size
- Substrate Width (dynamic): -

IS301-EGIRPE
- Plasma Opening: Ø 220 mm
- Matching: Integrated Remote Match
- RF Power: 3kW @ 13.56MHz
- Pressure Range: 1x10-4 ~ 1x10-2 mbar
- Substrate Size (static): up to 1100mm calotte/dome size
- Substrate Width (dynamic): -

IS400-EGIRPE
- Plasma Opening: Ø 250 mm
- Matching: Integrated Remote Match
- RF Power: 5kW @ 13.56MHz
- Pressure Range: 1x10-4 ~ 1x10-2 mbar
- Substrate Size (static): up to 1500mm calotte/dome size
- Substrate Width (dynamic): -

IS502-EGIRPE
- Plasma Opening: Ø 320 mm
- Matching: Integrated Remote Match
- RF Power: 7kW @ 13.56MHz
- Pressure Range: 1x10-4 ~ 1x10-2 mbar
- Substrate Size (static): up to 2000mm calotte/dome size
- Substrate Width (dynamic): -

IS1100x250-GRPE
- Plasma Opening: 1100mmx250mm
- Matching: Integrated Remote Match
- RF Power: 6kW @ 13.56MHz
- Pressure Range: 5x10-4 ~ 1x10-2 mbar
- Substrate Size (static): -
- Substrate Width (dynamic): 1000mm
Plasma Monitoring System (Faraday Cup CEA4)

The CCR Faraday Cup CEA4 Plasma Monitoring System through it allows to precisely. Out measure the plasma parameters as:
- Ion Energy Distribution IED
- Ion Energy
- Ion Current Density
- Ion Energy vs Time
Find out the best operational parameters for your existing and in particular new coater design and processes in order to ensure highest performances of your systems.


